
热门搜索:
代理日本品牌:OTSUKA大塚电子(薄膜测厚仪、相位差膜设备等)、USHIO牛尾点光源、CCS检查光源、Aitec艾泰克、REVOX莱宝克斯、ONOSOKKI小野测器、YAMATO雅马拓、KOSAKA小坂台阶仪、SEN特殊光源、TSUBOSAKA壶坂电机、NEWKON新光、TOKISANGYO东机产业、tokyokeiso东京计装、leimac雷马克、MIKASA米卡萨匀胶机、COSMO科斯莫、SAKURAI樱井无尘纸、TOE东京光电子、EYE岩崎UV灯管、SANKO山高、HOYA豪雅光源、日本IMV爱睦威地震仪、HOKUYO北阳电机、SAKAGUCHI坂口电热、ThreeBond三键胶水等.

产品中心
-
CEDAR思达
-
Stucchi思多奇
-
NITTO KOHKI日...
-
Sankei
-
KYOWA协和工业
- DIT东日技研
- AITEC艾泰克
-
SIGMAKOKI西格玛...
- REVOX莱宝克斯
- CCS 希希爱视
- SIMCO思美高
- POLARI0N普拉瑞
- HOKUYO北阳电机
- SSD西西蒂
- EMIC 爱美克
- TOFCO东富科
-
打印机
- HORIBA崛场
- OTSUKA大冢电子
- MITAKA三鹰
- EYE岩崎
- KOSAKA小坂
-
SAGADEN嵯峨电机
- TOKYO KEISO东...
- takikawa 日本泷...
- Yamato雅马拓
- sanko三高
- SEN特殊光源
-
SENSEZ 静雄传感器
- marktec码科泰克
- KYOWA共和
- FUJICON富士
- SANKO山高
-
Sugiyama杉山电机
-
Osakavacuum大...
-
YAMARI 山里三洋
- ACE大流量计
- KEM京都电子
- imao今尾
- AND艾安得
- EYELA东京理化
- ANRITSU安立计器
- JIKCO 吉高
- NiKon 尼康
- DNK科研
- Nordson诺信
- PISCO匹斯克
- NS精密科学
- NDK 日本电色
-
山里YAMARI
- SND日新
-
Otsuka大塚电子
- kotohira琴平工业
- YAMABISHI山菱
- OMRON欧姆龙
- SAKURAI樱井
- UNILAM优尼光
- ONO SOKKI小野测...
-
U-Technology...
- ITON伊藤
- chuhatsu中央发明...
- TOADKK东亚
- HOYA豪雅
- COSMOS日本新宇宙
-
UENO上野精机
- DSK电通产业
-
POLARION普拉瑞
- LUCEO鲁机欧
- ThreeBond三键
-
HAMAMASTU滨松
-
TML东京测器
- SHINAGAWA SO...
- IMV爱睦威
- custom 东洋计量
- yuasa 尤阿萨
- HAYASHI林时计
- SIBATA柴田科学
- SEN日森特殊光源
-
HSK 平原精机
-
SOMA相马光学
- iwata岩田
- MUSASHI武藏
- USHIO牛尾
- ACTUNI阿库图
- ORC欧阿希
- DRY-CABI德瑞卡比
- COSMO科斯莫
-
SHOWASOKKI昭和...
-
CHUBUSEKI中部精...
-
SAMCO萨姆肯
- navitar 纳维塔
- ASKER 高分子计器
- KOSAKA Labor...
- EMIC爱美克
-
OPTEX奥泰斯
- NISSIN日进电子
- TANDD 蒂和日
- FUJI TERMINA...
- TAKASAGO高砂
- TAKIKAWA泷川
- SUGAWARA菅原
- MACOME码控美
-
FURUKAWA古河
-
TSUBOSAKA壺坂
- mitutoyo 三丰
- HAYASHI 林时计
- HOZAN 宝山
- FEI SEM電子顕微鏡
- YUASA尤阿萨
- SAKAGUCHI坂口电...
-
MDCOM 株式会社
-
inflidge 英富丽
- RKC 理化工业
- MORITEX茉丽特
- LIGHTING 光屋L...
- TEITSU帝通
- Excel听音机
- SERIC索莱克
-
FUJI富士化学
-
TONCON拓丰
-
SHINKO新光电子
- Ono Sokki 小...
- 乐彩
- IIJIMA 饭岛电子
- THOMAS托马斯
- JIKCO吉高
- 分散材料研究所
-
NAVITAR纳维塔
- Cho-Onpa 超音波...
- revox 莱宝克斯
- Toki Sangyo ...
- SUPERTOOL世霸
- EIWA荣和
- FUJITERMINAL...
- TOYOX东洋克斯
- AMAYA天谷制作所
-
TSUBAKI NAKA...
- TOPCON 拓普康
- NIKKATO日陶
- ITOH伊藤
- NEWKON新光
- SIBATA柴田
-
TAISEI
-
MITSUI三井电气
-
加热器
产品详情
简单介绍:
我们的 MCPD 系列内联薄膜评估系统采用光学类型,可在非接触式和无损条件下检测薄膜厚度、浓度和颜色。
可测量薄膜厚度范围为 65nm 至 92μm,从薄膜到厚膜。 (折射率为1.5时)
测量原理为分光干涉方式,在实现高测量再现性的同时,还支持多层厚度测量。 由于采用专有算法可实现高速实时监控,因此我们提出了*适合在线胶片监视器的系统。
详情介绍:
特点
- 非常适合工艺过程中的薄膜高速测量
- *短曝光时间1ms~ ※根据规格
- 支持远程测量
- 膜厚测定范围65nm~92μm(SiO2转换)
基本配置

多点测量点切换支持系统
在多点测量点切换兼容系统中,通过在TD方向上预先将多分支光纤安装在任意宽度上,可以在不驱动光纤的情况下测量TD方向的薄膜厚度分布。 可用作涂层条件和实时监视器。
探测器和数据处理系统是一种类型,可通过光纤光路切换进行多点测量。
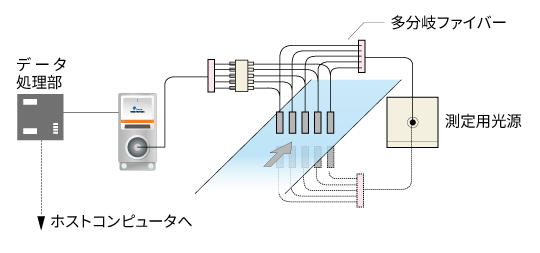
遍历单元对应系统
在支持遍历单元的系统中,通过在 TD 方向上驱动遍历单元,可以测量 TD 方向上的薄膜厚度分布,范围和间距均相同。 可用作涂层条件和实时监视器。
无需多个探测器或数据处理,即可通过驱动遍历单元进行多点测量。
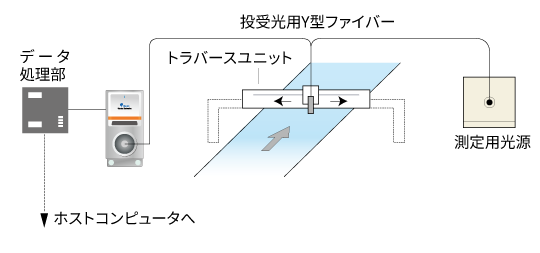
即使在真空环境中也能进行多点反射和透射光谱测量
通过使用适用于各种法兰的耐真空纤维,可以在高真空下测量反射和透射光谱。 此外,薄膜厚度计算不受基膜上下运动的影响,并且通过采用大分电子专有的算法,可以**测量薄膜,可用作实时监视器。
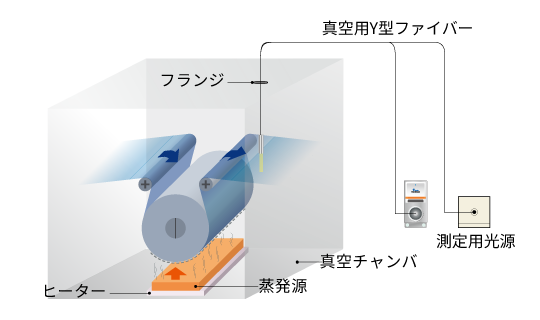
规格
MCPD-9800 规格
| 类型表达式 | MCPD-9800 | ||||||||
| 2285C | 3095C | 3683C | 311C | 916C | |||||
| 测量波长范围(nm) | 220~850 | 300~950 | 360~830 | 360~1100 | 900~1600 | ||||
| 薄膜厚度范围* | 65nm~35μm | 65nm~50μm | 65nm~45μm | 65nm~49μm | 180nm~92μm | ||||
| 薄膜厚度/反射/透射/延迟 | 〇 | ||||||||
| 颜色测量 | 〇 | × | |||||||
| 扫描时间 | 5ms~20s | 1ms~10s | |||||||
| 点直径 | φ1.2mm | ||||||||
| 纤维长度 | 1m~ 长度需要咨询 | ||||||||
※膜厚值n=1.5换算。 取决于规格
MCPD-6800 规格
| 类型表达式 | MCPD-6800 | |||
| 2285C | 3095C | 3683C | 3610C | |
| 测量波长范围(nm) | 220~850 | 300~950 | 360~830 | 360~1000 |
| 薄膜厚度范围* | 65nm~35μm | 65nm~50μm | 65nm~45μm | 65nm~49μm |
| 薄膜厚度/反射/透射/延迟/颜色测量 | 〇 | |||
| 扫描时间 | 16ms~65s | |||
| 点直径 | φ1.2mm | |||
| 纤维长度 | 1m~ 长度需要咨询 | |||
※膜厚值n=1.5换算。 取决于规格
产品留言
