

-
CEDAR思达
-
Stucchi思多奇
-
NITTO KOHKI日...
-
Sankei
-
KYOWA协和工业
- DIT东日技研
- AITEC艾泰克
-
SIGMAKOKI西格玛...
- REVOX莱宝克斯
- CCS 希希爱视
- SIMCO思美高
- POLARI0N普拉瑞
- HOKUYO北阳电机
- SSD西西蒂
- EMIC 爱美克
- TOFCO东富科
-
打印机
- HORIBA崛场
- OTSUKA大冢电子
- MITAKA三鹰
- EYE岩崎
- KOSAKA小坂
-
SAGADEN嵯峨电机
- TOKYO KEISO东...
- takikawa 日本泷...
- Yamato雅马拓
- sanko三高
- SEN特殊光源
-
SENSEZ 静雄传感器
- marktec码科泰克
- KYOWA共和
- FUJICON富士
- SANKO山高
-
Sugiyama杉山电机
-
Osakavacuum大...
-
YAMARI 山里三洋
- ACE大流量计
- KEM京都电子
- imao今尾
- AND艾安得
- EYELA东京理化
- ANRITSU安立计器
- JIKCO 吉高
- NiKon 尼康
- DNK科研
- Nordson诺信
- PISCO匹斯克
- NS精密科学
- NDK 日本电色
-
山里YAMARI
- SND日新
-
Otsuka大塚电子
- kotohira琴平工业
- YAMABISHI山菱
- OMRON欧姆龙
- SAKURAI樱井
- UNILAM优尼光
- ONO SOKKI小野测...
-
U-Technology...
- ITON伊藤
- chuhatsu中央发明...
- TOADKK东亚
- HOYA豪雅
- COSMOS日本新宇宙
-
UENO上野精机
- DSK电通产业
-
POLARION普拉瑞
- LUCEO鲁机欧
- ThreeBond三键
-
HAMAMASTU滨松
-
TML东京测器
- SHINAGAWA SO...
- IMV爱睦威
- custom 东洋计量
- yuasa 尤阿萨
- HAYASHI林时计
- SIBATA柴田科学
- SEN日森特殊光源
-
HSK 平原精机
-
SOMA相马光学
- iwata岩田
- MUSASHI武藏
- USHIO牛尾
- ACTUNI阿库图
- ORC欧阿希
- DRY-CABI德瑞卡比
- COSMO科斯莫
-
SHOWASOKKI昭和...
-
CHUBUSEKI中部精...
-
SAMCO萨姆肯
- navitar 纳维塔
- ASKER 高分子计器
- KOSAKA Labor...
- EMIC爱美克
-
OPTEX奥泰斯
- NISSIN日进电子
- TANDD 蒂和日
- FUJI TERMINA...
- TAKASAGO高砂
- TAKIKAWA泷川
- SUGAWARA菅原
- MACOME码控美
-
FURUKAWA古河
-
TSUBOSAKA壺坂
- mitutoyo 三丰
- HAYASHI 林时计
- HOZAN 宝山
- FEI SEM電子顕微鏡
- YUASA尤阿萨
- SAKAGUCHI坂口电...
-
MDCOM 株式会社
-
inflidge 英富丽
- RKC 理化工业
- MORITEX茉丽特
- LIGHTING 光屋L...
- TEITSU帝通
- Excel听音机
- SERIC索莱克
-
FUJI富士化学
-
TONCON拓丰
-
SHINKO新光电子
- Ono Sokki 小...
- 乐彩
- IIJIMA 饭岛电子
- THOMAS托马斯
- JIKCO吉高
- 分散材料研究所
-
NAVITAR纳维塔
- Cho-Onpa 超音波...
- revox 莱宝克斯
- Toki Sangyo ...
- SUPERTOOL世霸
- EIWA荣和
- FUJITERMINAL...
- TOYOX东洋克斯
- AMAYA天谷制作所
-
TSUBAKI NAKA...
- TOPCON 拓普康
- NIKKATO日陶
- ITOH伊藤
- NEWKON新光
- SIBATA柴田
-
TAISEI
-
MITSUI三井电气
-
加热器
OTSUKA大塚电子OPTM-A2光学测量膜厚计塔玛萨崎电子中国代理
OTSUKA大塚电子OPTM-A2光学测量膜厚计塔玛萨崎电子上海代理
OTSUKA大塚电子OPTM-A2光学测量膜厚计塔玛萨崎电子江苏代理
OTSUKA大塚电子OPTM-A2光学测量膜厚计塔玛萨崎电子浙江代理
OTSUKA大塚电子OPTM-A2光学测量膜厚计塔玛萨崎电子安徽代理
OTSUKA大塚电子OPTM-A2光学测量膜厚计塔玛萨崎电子山东代理
- **反射率测量
- 膜厚分析
- 光学常数分析(n:折射率,k:消光系数)
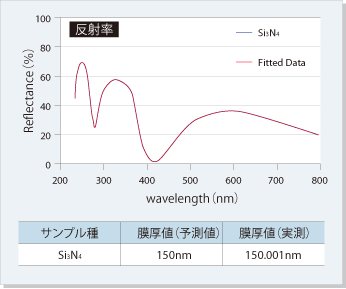
半导体晶体管通过控制电流来传输信号,并嵌入绝缘膜以绝缘晶体管,以防止电流泄漏和另一个晶体管的电流通过任意通道。 绝缘膜含有SiO2使用(二氧化硅)和SiN(氮化硅)。 二氧化硅2用作绝缘膜,SiN为SiO2作为更高的介电常数绝缘膜或作为不必要的SiO2在去除 CMP 时用作塞子,然后去除 SiN。 因此,必须测量这些薄膜厚度,以确保绝缘薄膜的性能和**的过程控制。
![SiO2 SiN薄膜厚度测量 [FE-0002]](https://www.otsukael.jp/upload/files/OPTM_app_01.jpg)
![SiO2 SiN薄膜厚度测量 [FE-0002]](https://www.otsukael.jp/upload/files/FE-300_app_02.jpg)
![SiO2 SiN薄膜厚度测量 [FE-0002]](https://www.otsukael.jp/upload/files/FE-300_app_03.jpg)
液晶显示器一般具有右图所示的结构。 CF在一个像素处具有RGB,是一种非常高清的微图案。 主流的CF成膜方法是将颜料基彩色抗蚀剂涂在玻璃的整个表面,通过光刻技术曝光和显影图像,每个RGB只留下图案化部分。 此时,管理薄膜厚度值很重要,因为如果彩色抗蚀剂的厚度不是恒定的,则会导致图案变形并作为滤色器的颜色变化。
![彩色抗蚀剂 (RGB) 薄膜厚度测量 [FE-0003]](https://www.otsukael.jp/upload/files/OPTM_app_02.jpg)
![彩色抗蚀剂 (RGB) 薄膜厚度测量 [FE-0003]](https://www.otsukael.jp/upload/files/APP3-2.jpg)
近年来,使用具有各种功能的高性能薄膜的产品已经变得司空见惯,并且根据用途,可能需要在薄膜表面具有摩擦,冲击,耐热和耐化学性等性能的保护膜。 通常形成硬涂层(HC)膜作为保护膜层,但是由于HC膜的厚度可能无法用作保护膜,可能会在薄膜上产生翘曲,或者可能导致外观不均匀或变形,因此有必要控制HC层的厚度值。
![硬涂层薄膜厚度测量 [FE-0004]](https://www.otsukael.jp/upload/files/OPTM_app_03.jpg)
![硬涂层薄膜厚度测量 [FE-0004]](https://www.otsukael.jp/upload/files/APP4-2.jpg)
ITO(氧化铟锡)是一种用于液晶显示器的透明电极材料,在成膜后通过退火(热处理)来提高导电性和色度。 那时,氧态和结晶度也会发生变化,但这种变化可能会随着薄膜的厚度逐步改变斜率,并且不能将其视为具有光学均匀成分的单层薄膜。 对于这样的 ITO,我们将介绍一个使用倾斜模型测量上下界面 nk 倾斜度的示例。
![利用边坡模型对ITO进行结构分析 [FE-0005]](https://www.otsukael.jp/upload/files/OPTM_app_04.jpg)
![利用边坡模型对ITO进行结构分析 [FE-0005]](https://www.otsukael.jp/upload/files/APP5-2.jpg)
如果样品表面有粗糙度,则可以将表面粗糙度建模为“粗糙度层”,其中大气(空气)和膜厚材料以1:1的比例混合以分析粗糙度和膜厚。 在这里,我们描述了一个测量表面粗糙度为几纳米的SiN(氮化硅)的示例。
![考虑表面粗糙度的膜厚测量 [FE-0007]](https://www.otsukael.jp/upload/files/OPTM_app_05.jpg)
![考虑表面粗糙度的膜厚测量 [FE-0007]](https://www.otsukael.jp/upload/files/APP7-2.jpg)
干涉滤光片通过沉积膜厚和NK控制的膜,可以在指定的波长波段内具有任意的反射率和透射率。 其中,*高精度的薄膜是通过多次重复薄膜作为高折射率层和低折射率层的一对(组)而形成的。 描述了使用超晶格模型测量和分析此类样品的示例。
![使用超晶格模型测量干涉滤光片 [FE-0009]](https://www.otsukael.jp/upload/files/OPTM_app_06.jpg)
![使用超晶格模型测量干涉滤光片 [FE-0009]](https://www.otsukael.jp/upload/files/APP9-2.jpg)
OLED材料对氧气和湿气敏感,在正常气氛中可能会改变或损坏。 因此,成膜后,立即用玻璃密封。 描述了在密封时通过玻璃测量薄膜厚度的示例。 玻璃和中间空气层采用非干涉层模型。
![使用无干扰层模型测量封装的OLED材料 [FE-0010]](https://www.otsukael.jp/upload/files/OPTM_app_07.jpg)
![使用无干扰层模型测量封装的OLED材料 [FE-0010]](https://www.otsukael.jp/upload/files/APP10-2%281%29.jpg)
为了使用*小二乘法进行拟合并分析薄膜厚度值(D),需要材料的NK。 如果 nk 未知,它将 d 和 nk 解析为变量参数。 但是,对于D为100nm或更小的超薄膜,D和NK无法分离,这会降低精度并且可能无法提供准确的D。 在这种情况下,测量具有不同d的多个样品,并假设nk相同,则执行同时分析(多点相同分析)。 这使得准确找到 nk 和** d 成为可能。
![使用多点识别分析测量NK未知超薄膜 [FE-0013]](https://www.otsukael.jp/upload/files/OPTM_app_08.jpg)
![使用多点识别分析测量NK未知超薄膜 [FE-0013]](https://www.otsukael.jp/upload/files/APP13-2.jpg)
对于基板表面未反射的粗糙度较大的样品,散射会降低测量的光,并使测量的反射率低于实际水平。 通过使用界面系数考虑基板表面反射率的降低,可以测量基板上薄膜的膜厚值。 例如,我们将描述一个测量发际线成品铝基板上树脂膜厚度的示例。
![使用界面系数在基板上测量薄膜厚度 [FE-0015]](https://www.otsukael.jp/upload/files/OPTM_app_09.jpg)
![使用界面系数在基板上测量薄膜厚度 [FE-0015]](https://www.otsukael.jp/upload/files/APP15-2.jpg)
DLC(类金刚石碳)是一种无定形碳基材料。 它具有高硬度、低摩擦系数、耐磨性、电绝缘性、高阻隔性、表面改性和与其他材料的亲和力提高等特点,并用于各种应用。 近年来,根据每种应用对薄膜厚度测量的需求不断增加。
DLC厚度测量通常通过破坏性检查进行,其中制备监视器样品并用电子显微镜观察样品的横截面,但大冢电子采用的光学干涉膜测厚仪可以无损高速测量。 通过改变测量波长范围,可以测量从超薄膜到超厚薄膜的各种薄膜厚度。
通过采用独特的显微镜光学系统,可以实际测量形状的样品而不是监视器样品。 此外,通过在用监视器检查测量位置的同时进行测量,可用于分析异常原因。
我们为各种形状提供定制的倾斜和旋转平台。 可以测量实际样品中的任何多个位置。
对于光学干涉膜厚系统的弱点,除非知道材料的光学常数(NK),否则无法进行准确的膜厚测量的问题,通过使用我们**的分析方法同时分析预先制备的多个不同厚度的样品,可以获得比传统方法更高的NK:多点分析。
通过使用NIST(美国国家标准与技术研究院)认证的标准样品进行校准来保证可追溯性。
![适用于各种应用的DLC涂层厚度测量]](https://www.otsukael.jp/upload/files/DLC-0%282%29.jpg)
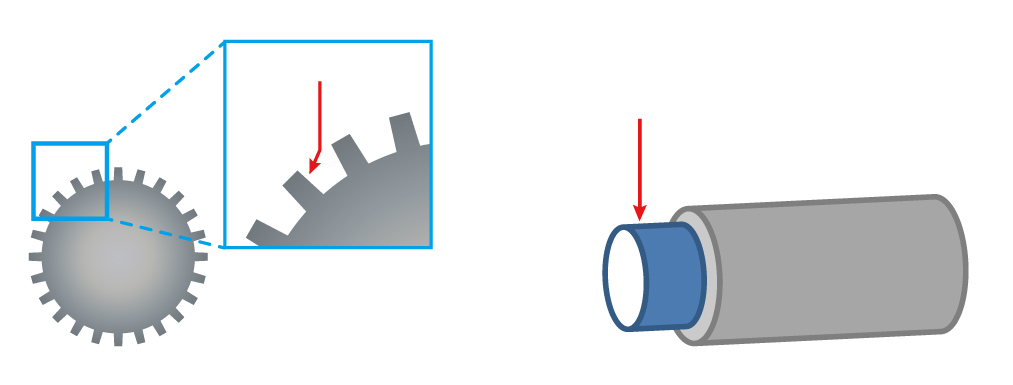
○ 齿轮 ○ 轴
■类金刚石薄膜厚度测量示例
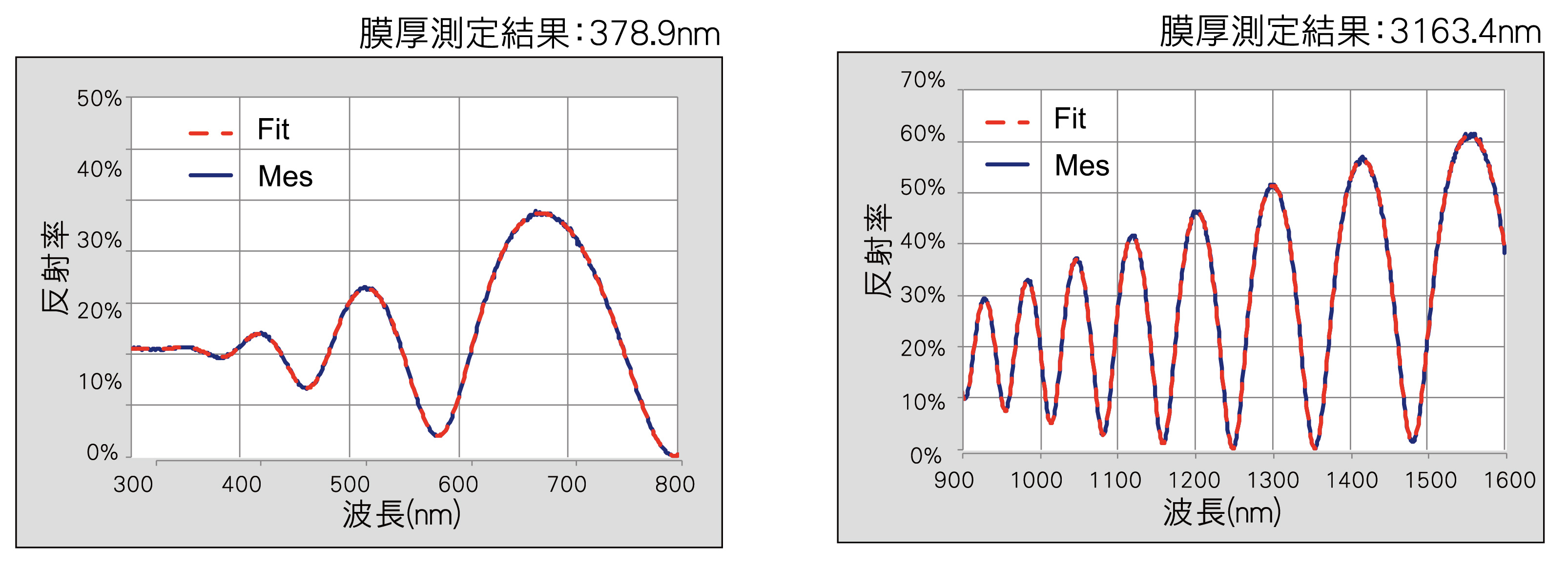
代理品牌:OTSUKA大塚电子(薄膜测厚仪、偏光片检测、纳米粒度分析仪、ZATA电位仪、相位差膜·光学材料检查设备、液晶层间隙量测设备等)、SANKO三高、NPM日脉、东机产业(粘度计)、CCS(视检查光源)、Aitec(视检查光源)、REVOX莱宝克斯(视检查光源)、EYE岩崎(UV汞灯)、SEN 日森、SERIC索莱克、各类日本光源 索尼克(风速计、流量计等)、坂口电热(加热器、制冷片)、NEWKON新光(针孔机)、NS精密科学(柱塞泵、高压耐腐蚀防爆泵) 、SIBATA柴田科学、SAKURAI樱井
优势品牌:AND艾安得、TOA-DKK东亚电波、JIKCO吉高、RKC理化工业、KYOWA共和、IIJIMA饭岛电子、HORIBA堀场、EXCEL艾库斯、HEIDON新东科学、USHIO牛尾、TOPCON拓普康、ORC欧阿西、SEKONIC日本世光、Tokyokoden东京光电、DSK电通、SAGADEN嵯峨电机、FUNATECH船越龙、HIKARIYA光屋、POLARION普拉瑞、HAYASHI林时计、MACOME码控美、TML东京测器等等各日本品牌工业产品
塔玛萨崎电子(苏州)有限公司代理、直营各日本品牌工业产品,联系人:张小姐
联系电话(微信):15902189399
